【課題解決】パッケージ基板におけるダイシングの課題を解決
パッケージ基板の高密度化と薄型化が進むなか、後工程の切断(ダイシング)にも一層の精度が求められるようになっています。とくに多層構造の基板では、構成材料の異なる層を安定して切断する必要があり、加工の難易度が上がっています。
本コラムでは、半導体製造の後工程におけるパッケージ基板の切断の課題と、ダイヤモンドブレードによる改善ポイントをご紹介します。
パッケージ基板の切断の課題

パッケージ基板の切断(ダイシング)は、ウェーハやパッケージ上のICをチップに切り出す作業で、最終製品の信頼性や歩留まりに直結する重要な工程です。
従来、ダイシングにはブレードを高速回転させて切断する「ダイシングマシン」が使われますが、切れ味の安定性に課題があり、基板にカケやチッピングが発生することがありました。さらに、基板に含まれる銅がブレードに付着し、切断能力の低下を招くこともあります。
また、ブレードの偏摩耗が起こりやすく、工具寿命の低下や交換頻度の増加につながり、生産性にも影響を及ぼしていました。
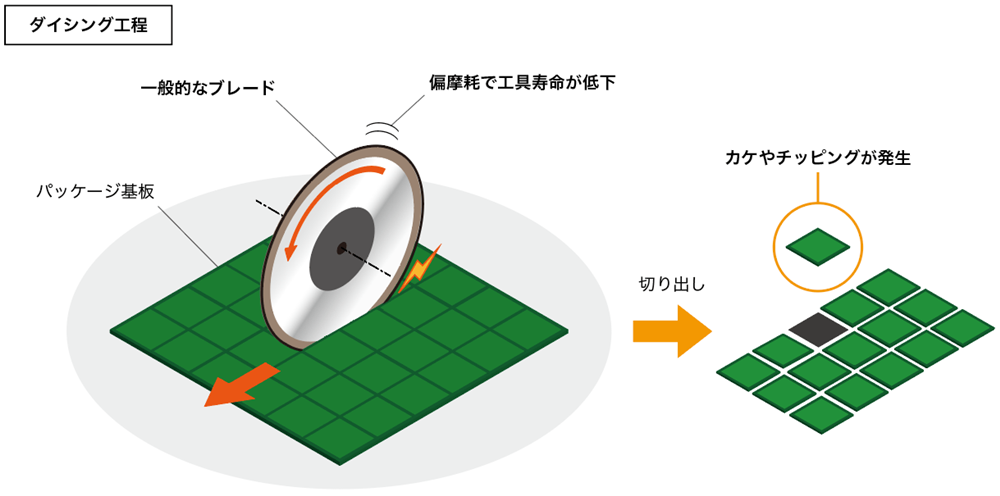
〈課題のポイント〉
- 基板にカケやチッピングが発生
- ブレードに銅が付着し、切断能力が低下
- ブレードが偏摩耗し、工具寿命が短い
ダイヤモンドブレードによる課題解決
高性能なダイシングマシンを使っていても、ブレードの選定次第で、その性能を十分に引き出せないことがあります。そこで注目されているのが、東京ダイヤモンド工具製作所のダイヤモンドブレードです。
「パッケージ基板切断用ダイヤモンドブレード」は、ダイシング専用に設計されており、切断面の品質向上と工具寿命の延長を両立します。
刃先には独自のVフェース形状を採用。銅の付着による切れ味低下を防ぎつつ、切断初期に発生しやすいカケやチッピングを抑えます。また直進性にも優れており、偏摩耗を防ぎながら長時間にわたって安定した切断性能を維持することができます。
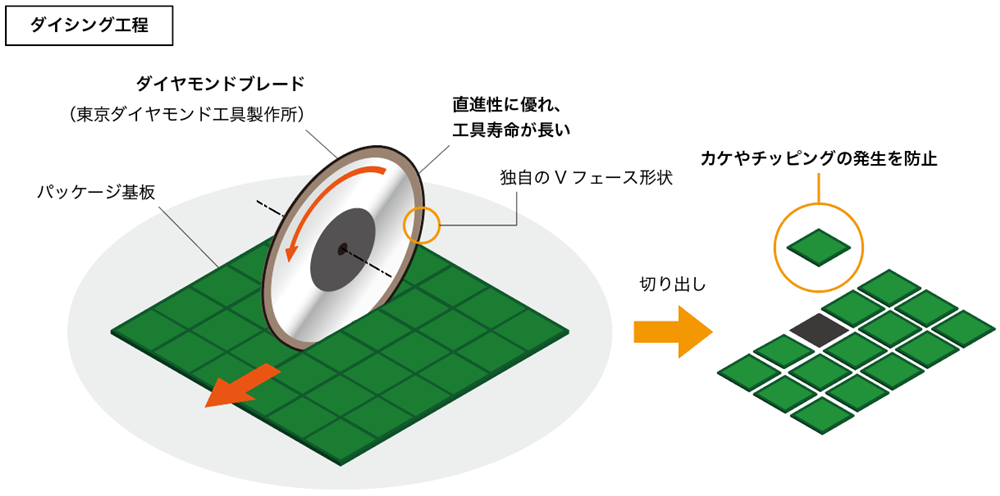
〈改善のポイント〉
- カケやチッピングの発生を防止
- 銅の付着による切れ味低下を抑制
- 直進性に優れ、工具寿命が長い
パッケージ基板のダイシングにおすすめの工具

パッケージ基板切断用ダイヤモンドブレード
切れ味がよく切断品質が良好なメタルボンドブレードです。金属ベース(台金)付のリムソータイプブレードとオールブレードタイプがあります。パッケージ基板の他にも、積層セラミックス、磁性材料、光学ガラスなどの加工に幅広く使用されています。
今すぐ!ご相談ください
パッケージ基板のダイシングでは、わずかなカケやチッピングが製品の歩留まりや品質を大きく左右します。薄型化・多層化が進むなか、従来のブレードでは対応しきれない場面も増えています。
東京ダイヤモンド工具製作所では、加工条件やブレードの外径・刃厚に応じて、最適な仕様をご提案しています。
ブレードの選定を見直すだけで、加工品質と工具寿命の両立が可能になり、国内外の半導体製造現場から寄せられるご相談も年々増えています。
ダイシング工程の品質向上と生産性向上を図りたい方は、ぜひ一度ご相談ください。

