SiCウェーハ平面研削の【粗加工】におけるホイールの長寿命化
【SiCウェーハの粗加工の課題】
低炭素社会における省電力化の流れにおいて、より効率的なパワーデバイス基板となるSiCウェーハが注目され高い成長が期待されています。ですがSiCウェーハは硬度が高い難削材として知られており、加工時間が掛かる・加工する砥石(ダイヤモンドホイール)の摩耗が激しという課題がありました。
そのためウェーハの加工コストが従来のシリコンウェーハと比較してSiCウェーハは非常に高く、特に取り代が多いウェーハ平面研削での粗加工工程では、安定した加工性を有する高寿命なダイヤモンドホイールが求められていました。
【有気孔ビトリファイドボンドホイールで解決】
当社の有気孔ビトリボンドホイール「ベガ」は、独自の砥石組織コントロール技術によって開発した新ボンドホイールです。特にSiCウェーハの平面研削での粗研削加工で加工性とホイール寿命を両立しています。
6インチSiCウェーハもノンドレスで加工が可能です。優れた耐摩耗性でホイールあたりのウェーハ加工可能枚数を増やし、ウェーハの加工コスト低減に貢献します。
■従来品から大幅に寿命向上(ホイール摩耗率15%以下)
■切込速度0.6μm/secで安定した加工性を達成
■研削性重視と寿命重視の2タイプをラインナップ
■バルクウェーハの粗研削工程(Si面)、デバイス工程でのウェーハバックグラインド(C面)で実績
■研削後表面粗さ Ra17nm-20nm

.png)
有気孔ビトリボンドホイールの摩耗率/研削性データ
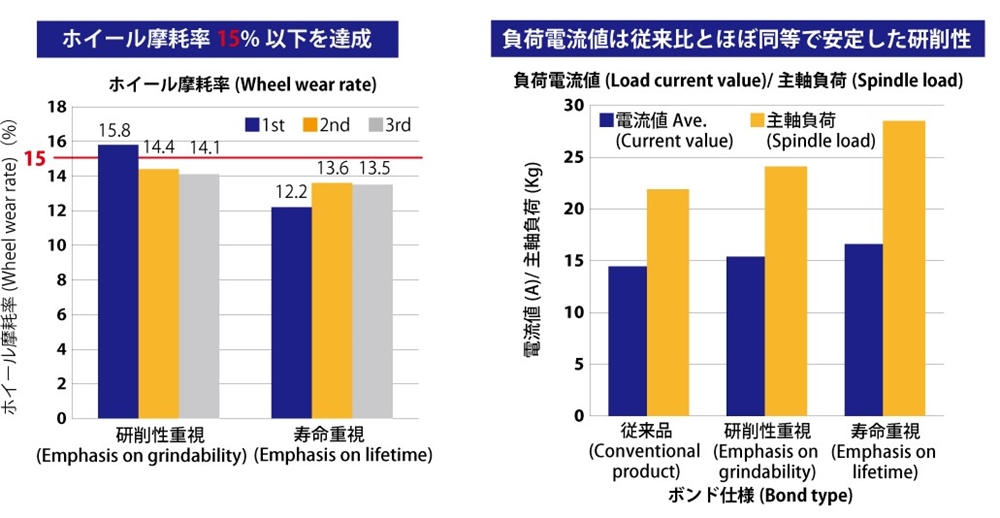
摩耗率/研削性のテスト加工条件
研削盤 : HRG300 (東京精密)
粒度 : SD2000
ホイールサイズ : 246D-2.8W-32P
ホイール回転数 : 2,000rpm~2,500rpm
切込速度 : 0.6μm/sec
切込量 : 150μm
被削材 : 6inch SiC Wafer(4H-N)
※社内に評価装置・環境を整備。
半導体ウェーハの加工に最適な研削工具
化合物半導体ウェーハ平面研削用 「ベガ」有気孔ビトリファイドボンドホイール

ボンド種: 有気孔ビトリファイド
粒 度 : #1000~#3000(粗加工用)
【対象加工素材】
SiC、GaN、GaAs、LT/LN
■安定した加工性と高寿命を両立
■社内にホイール評価設備・環境を整備しておりウェーハ支給での評価テストも可能

